QR-Code

Produkte
Kontaktiere uns


Fax
+86-579-87223657

Email

Adresse
Wangda Road, Ziyang Street, Kreis Wuyi, Stadt Jinhua, Provinz Zhejiang, China
Siliziumkarbidsubstrate haben viele Mängel und können nicht direkt verarbeitet werden. Ein spezifischer Einzelkristall -Dünnfilm muss durch einen epitaxialen Prozess auf ihnen angebaut werden, um Chip -Wafer zu machen. Dieser dünne Film ist die epitaxiale Schicht. Fast alle Silizium -Carbid -Geräte werden auf epitaxialen Materialien realisiert. Hochwertige Siliziumkarbid-homogene epitaxiale Materialien sind die Grundlage für die Entwicklung von Silizium-Carbid-Geräten. Die Leistung von epitaxialen Materialien bestimmt direkt die Realisierung der Leistung von Siliziumcarbidgeräten.
Hochstromige und mit hoher Zuverlässigkeit von Silizium-Carbid-Geräten haben strengere Anforderungen an die Oberflächenmorphologie, die Defektdichte, die Doping und die Gleichmäßigkeit der Dicke von epitaxialen Materialien vorgeschlagen. Großgrößen, geringe Dichte und hoher Uniformität mit geringer DefekteSiliziumkarbid -Epitaxieist der Schlüssel zur Entwicklung der Siliziumkarbidindustrie geworden.
Die Herstellung von hochwertiger QualitätSiliziumkarbid -Epitaxieerfordert fortschrittliche Prozesse und Ausrüstung. Die am weitesten verbreitete Methode zur epitaxialen Wachstumsmethode von Siliziumcarbid ist die chemische Dampfabscheidung (CVD), die die Vorteile einer präzisen Kontrolle der epitaxialen Filmdicke und der Dopingkonzentration, weniger Defekte, einer moderaten Wachstumsrate und der automatischen Prozessregelung aufweist. Es ist eine zuverlässige Technologie, die erfolgreich kommerzialisiert wurde.
Die CVD-Epitaxie von Siliziumcarbid verwendet im Allgemeinen CVD-Geräte mit heißer Wand oder warmem Wand, wodurch die Fortsetzung der epitaxialen Schicht 4H Kristall sic unter höheren Wachstumstemperaturbedingungen (1500-1700 ℃) sicherstellt. Nach Jahren der Entwicklung können CVD mit heißer Wand oder warme Wand in horizontale horizontale Strukturreaktoren und vertikale vertikale Strukturreaktoren gemäß der Beziehung zwischen der Richtung des Einlassgasstroms und der Substratoberfläche unterteilt werden.
Die Qualität des Epitaxialofens von Siliziumkarbid -Epitaxen hat hauptsächlich drei Indikatoren. Die erste ist die epitaxiale Wachstumsleistung, einschließlich der Gleichmäßigkeit der Dicke, der Einheitlichkeit von Doping, der Defektrate und der Wachstumsrate; Die zweite ist die Temperaturleistung der Ausrüstung selbst, einschließlich Heiz-/Kühlrate, maximaler Temperatur, Temperaturgleichmäßigkeit; und schließlich die Kostenleistung der Ausrüstung selbst, einschließlich der Preis- und Produktionskapazität der Einheit.
HOT-Wand Horizontale CVD, warme Wandplanetary CVD und Quasi-HOT-Wall-vertikale CVD sind die Mainstream-Lösungen für epitaxiale Geräte-Technologie, die in dieser Phase kommerziell angewendet wurden. Die drei technischen Geräte haben auch eigene Eigenschaften und können entsprechend den Bedürfnissen ausgewählt werden. Das Strukturdiagramm ist in der folgenden Abbildung dargestellt:

Das horizontale CVD-System mit heißer Wand ist im Allgemeinen ein großer Wachstumssystem mit einem Waffen, das von Luftflotation und Drehung angetrieben wird. Es ist leicht, gute In-Wafer-Indikatoren zu erreichen. Das repräsentative Modell ist PE1O6 von LPE Company in Italien. Diese Maschine kann die automatische Belastung und Entladung von Wafern bei 900 ℃ realisieren. Die Hauptmerkmale sind eine hohe Wachstumsrate, einen kurzen Epitaxialzyklus, eine gute Konsistenz innerhalb des Wafers und zwischen den Öfen usw. Es hat den höchsten Marktanteil in China.

Laut offiziellen LPE-Berichten, kombiniert mit der Verwendung von großen Benutzern, können die 100-150 mm (4-6 Zoll) 4H-Sic-Epitaxialwaferprodukte mit einer Dicke von weniger als 30 & mgr; m, die durch den PE1O6-Epitaxialdofen produziert werden, die folgenden Indikatoren erreichen: Intrafer-Waffel-Epitaxials-Dokument ohne Einunformation ohne Einheit ≤ 2%. Dichte ≤ 1cm-2, Oberflächenfehlerfreier Bereich (2 mm × 2 mm Einheitszelle) ≥ 90%.
Inländische Unternehmen wie JSG, CETC 48, Naura und NASO haben monolithische Siliziumcarbid-Epitaxialgeräte mit ähnlichen Funktionen entwickelt und groß angelegte Sendungen erreicht. Zum Beispiel veröffentlichte JSG im Februar 2023 eine 6-Zoll-Doppel-Wafer-SIC-Epitaxialgeräte. Das Gerät verwendet die oberen und unteren Schichten der oberen und unteren Schichten der Graphitenteile der Reaktionskammer, um zwei epitaxiale Wafer in einem einzelnen Ofen zu züchten, und die oberen und unteren Prozessgase können getrennt reguliert werden, wobei eine Temperaturdifferenz von ≤ 5 ° C, die effektiv den ständigen ständigen Unterhalt der unzureichenden Produktionskapazität von monolithischem monolithischem monolithischem, monolithischem Horizontal -Epital -Epital -Epital -epitalem Eptalsepital -Eptal -epitales eptales eptales eptales eptales eptonsep.SIC -Beschichtung Halfmoon -TeileWir liefern den Benutzern 6 Zoll und 8 -Zoll -Halbmoon -Teile.

Das warmwandige planetarische CVD-System mit einer planetarischen Anordnung der Basis zeichnet sich durch das Wachstum mehrerer Wafer in einem einzelnen Ofen und einer hohen Ausgangseffizienz aus. Repräsentative Modelle sind die epitaxialen Ausrüstung von AIXG5WWC (8x150 mm) und G10-SIC (9 × 150 mm oder 6 × 200 mm).
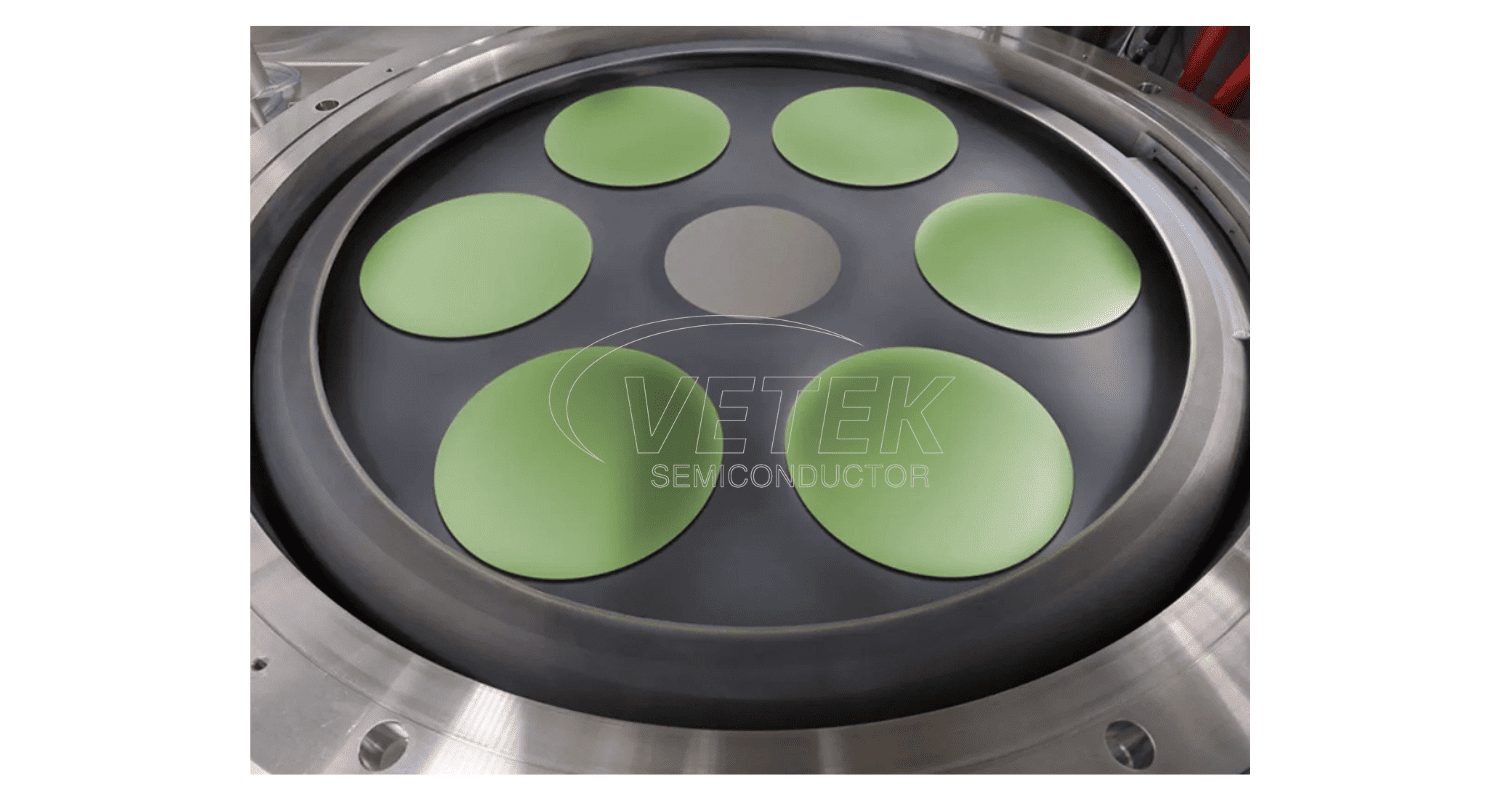
Laut dem offiziellen Bericht von Aixtron kann die 6-Zoll-4H-SCIC-epitaxialen Waferprodukte mit einer Dicke von 10 & mgr; m, die durch den G10-Epitaxialofen produziert wird: die folgenden Indikatoren: Inter-Wafer-Epitaxialdicke von ± 2,5%, Intraer-Wafer-Epitaxi-Dicke-dicker Dicke von ± 2,5%, Intraer-Waffer-Epitaxi-Dicke-Uniformität 2%, 2%ig. Konzentration Ungleichmäßigkeit <2%.
Bisher wird diese Art von Modell von inländischen Nutzern selten verwendet, und die Stapelproduktionsdaten sind nicht ausreichend, was in gewissem Maße die technische Anwendung einschränkt. Aufgrund der hohen technischen Hindernisse für Multi-Wafer-Epitaxialöfen hinsichtlich der Temperaturfeld- und Durchflussfeldkontrolle befindet sich die Entwicklung ähnlicher Haushaltsgeräte noch in der Forschungs- und Entwicklungsphase, und es gibt kein alternatives Modell. In der Zwischenzeit können wir Aixtron-planetarische Anfälligkeiten mit 6 Zoll und 8-Zoll-TAC-Coating oder SIC-Beschichtungen zur Verfügung stellen.
Das quasi-hot-wall-vertikale CVD-System dreht sich hauptsächlich mit hoher Geschwindigkeit durch externe mechanische Unterstützung. Sein Merkmal ist, dass die Dicke der viskosen Schicht durch einen niedrigeren Reaktionskammerdruck effektiv reduziert wird, wodurch die epitaxiale Wachstumsrate erhöht wird. Gleichzeitig hat seine Reaktionskammer keine obere Wand, auf der SIC -Partikel abgelagert werden können, und es ist nicht einfach, fallende Objekte zu erzeugen. Es hat einen inhärenten Vorteil bei der Defektkontrolle. Repräsentative Modelle sind die einzelnen-epitaxialen Öfen Epirevos6 und Epirevos8 von Japans Nufflare.
Laut Nufflare kann die Wachstumsrate des EPIREVOS6-Geräts mehr als 50 μm/h erreichen, und die Oberflächendefektdichte des epitaxialen Wafers kann unter 0,1 cm-² kontrolliert werden; In Bezug auf die Gleichmäßigkeitskontrolle berichtete der Nufflare-Ingenieur Yoshiaki Daigo die intra-Wafel-Gleichmäßigkeitsergebnisse eines 10 & mgr; m dicken 6-Zoll-epitaxialen Wafers mit Epirevos6, und die Intra-Wafer-Dicke und die Doping-Konzentration ohne Uniform, die 1% und 2,6% dicken.Oberer Graphitzylinder.
Gegenwärtig haben Hersteller von inländischen Geräten wie die dritte Generation und JSG epitaxiale Geräte mit ähnlichen Funktionen entworfen und eingeführt, sie wurden jedoch nicht in großem Maßstab verwendet.
Im Allgemeinen haben die drei Arten von Geräten ihre eigenen Merkmale und belegen einen bestimmten Marktanteil an unterschiedlichen Anwendungsbedürfnissen:
Die horizontale CVD-Struktur mit heißer Wand verfügt über eine extremschnelle Wachstumsrate, Qualität und Gleichmäßigkeit, einfache Gerätebetrieb und -wartung sowie reife großflächige Produktionsanwendungen. Aufgrund des Ein-Wafel-Typs und der häufigen Wartung ist die Produktionseffizienz jedoch gering. Die Warmwandplanetary CVD nimmt im Allgemeinen ein 6 (Stück) × 100 mm (4 Zoll) oder 8 (Stück) × 150 mm (6 Zoll) -Benstruktur an, was die Produktionseffizienz des Geräts in Bezug auf die Produktionskapazität erheblich verbessert, aber es ist schwierig, die Konsistenz mehrerer Teile zu kontrollieren, und der Produktionsertrag ist immer noch das größte Problem. Die Quasi-HOT-Wall-Vertikale CVD hat eine komplexe Struktur, und die Qualitätsfehlerkontrolle für die epitaxiale Waferproduktion ist ausgezeichnet, was eine extrem reichhaltige Wartungs- und Nutzungserfahrung erfordert.
Schnelle Wachstumsrate
einfach Ausrüstungsstruktur und
Bequeme Wartung
Große Produktionskapazität
hohe Produktionseffizienz
Gute Produktfehlerkontrolle
Lange Reaktionskammer
Wartungszyklus
Komplexe Struktur
schwer zu kontrollieren
Produktkonsistenz
Komplexe Ausrüstungsstruktur,
Schwierige Wartung
Vertreter
Ausrüstung
Hersteller
Horizontale CVD heißer Wand
Warme Wandplanetary CWD
Quasi-Hot-Wall-Vertikale CTD
Vorteile
Nachteile
Kurzer Wartungszyklus
Italien LPE, Japan Tel.
Deutschland Aixtron
Japan Nufflare
Mit der kontinuierlichen Entwicklung der Branche werden diese drei Arten von Geräten in Bezug auf die Struktur iterativ optimiert und verbessert, und die Ausrüstungskonfiguration wird immer perfekter und spielt eine wichtige Rolle bei der Übereinstimmung der Spezifikationen von epitaxialen Wafern mit unterschiedlichen Dicken und Defektanforderungen.



+86-579-87223657


Wangda Road, Ziyang Street, Kreis Wuyi, Stadt Jinhua, Provinz Zhejiang, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alle Rechte vorbehalten.
Links | Sitemap | RSS | XML | Datenschutzrichtlinie |
