QR-Code

Produkte
Kontaktiere uns


Fax
+86-579-87223657

Email

Adresse
Wangda Road, Ziyang Street, Kreis Wuyi, Stadt Jinhua, Provinz Zhejiang, China
Siliziumcarbid ist eines der idealen Materialien, um Hochtemperatur-, Hochleistungs-, Hochleistungs- und Hochspannungsgeräte herzustellen. Um die Produktionseffizienz zu verbessern und die Kosten zu senken, ist die Vorbereitung großer Siliziumkarbidsubstrate eine wichtige Entwicklungsrichtung. Anstrengungen auf die Prozessanforderungen von8-Zoll-Siliziumcarbid (sic) EinkristallwachstumDer Wachstumsmechanismus des PVT -Verfahrens (PVT) -Methode (Physikalischer Dampftransport) wurde analysiert, das Heizsystem (TAC Guide Ring, TAC -beschichteter Tiegel,TAC beschichtete Ringe, TAC-beschichtete Platte, TAC-beschichtete Drei-Petal-Ring, TAC-beschichtete Dreipetal-Tiegel, TAC-beschichtete Halter, poröser Graphit, weiche Filz, starren Filz mit sic-beschichteten Kristallwachstumssuszeptor und andereSic Einkristallwachstumsprozess Ersatzteilewerden von Vetek Semiconductor bereitgestellt.
Einführung
Siliziumcarbid (SIC) ist ein typischer Vertreter der Halbleitermaterialien der dritten Generation. Es hat Leistungsvorteile wie eine größere Bandgap -Breite, ein höheres Elektrofeld mit höherem Breakdown und eine höhere thermische Leitfähigkeit. Es ist gut in hohen Temperaturen, hohen Druck- und Hochfrequenzfeldern und ist zu einer der Hauptanweisungen für die Entwicklungsentwicklung im Bereich der Halbleitermaterialtechnologie geworden. Gegenwärtig verwendet das industrielle Wachstum von Siliziumcarbidkristallen hauptsächlich den physischen Dampftransport (PVT), der komplexe Probleme mit mehrphysischen Feldkopplungen von Mehrphasen-, Mehrkomponenten-, Mehrfachwärm- und Massenübertragungs- und magnetoelektrischen Wärmeflusswechselwirkung umfasst. Daher ist das Design des PVT -Wachstumssystems schwierig und die Messung und Kontrolle des Prozessesparameters während derKristallwachstumsprozessist schwierig, was zu Schwierigkeiten bei der Kontrolle der Qualitätsdefekte der erwachsenen Siliziumkarbidkristalle und der kleinen Kristallgröße führt, so dass die Kosten für Geräte mit Siliziumkarbid bei der Substrat hoch bleiben.
Silizium -Carbid -Herstellung von Geräten ist die Grundlage für die Silizium -Carbid -Technologie und die industrielle Entwicklung. Das technische Niveau, die Prozessfähigkeit und die unabhängige Garantie für ein Einkristallwachstum von Siliziumcarbid sind der Schlüssel zur Entwicklung von Siliziumcarbidmaterialien in Richtung großer Größe und hoher Ertrag und auch die Hauptfaktoren, die die Halbleiterindustrie der dritten Generation in Richtung niedriger Kosten und großer Maßstab entwickeln. In Halbleitergeräten mit Siliziumcarbid -Einkristall als Substrat macht der Wert des Substrats den größten Anteil von etwa 50%aus. Die Entwicklung von großgröße hochwertigen Siliziumcarbidkristallwachstumsausrüstung, Verbesserung der Ausbeute und Wachstumsrate von Einkristallsubstraten von Siliziumcarbid und die Reduzierung der Produktionskosten sind für die Anwendung verwandter Geräte von entscheidender Bedeutung. Um die Produktionskapazitätsversorgung zu erhöhen und die durchschnittlichen Kosten für Siliziumcarbidgeräte weiter zu senken, ist die Erweiterung der Größe der Siliziumcarbid -Substrate eine der wichtigsten Möglichkeiten. Gegenwärtig beträgt die Größe des internationalen Mainstream -Silizium -Carbid -Substrats 6 Zoll und es hat sich schnell auf 8 Zoll voranschreitet.
Zu den Haupttechnologien, die in der Entwicklung von Einkristallwachstumsöfen von 8-Zoll-Siliziumkarbid-Einkarbid gelöst werden müssen, gehören: (1) Design einer großgrößen thermischen Feldstruktur, um einen kleineren Radialtemperaturgradienten und einen größeren Längs-Temperaturgradienten zu erhalten, der für das Wachstum von 8-Zoll-Silizium-Carbidkristallen geeignet ist. . (3) Automatische Steuerung der Prozessparameter unter dynamischen Bedingungen, die den Bedürfnissen eines qualitativ hochwertigen Einzelkristallwachstumsprozesses entsprechen.
1 PVT -Kristallwachstumsmechanismus
Die PVT -Methode besteht darin, Einzelkristalle aus Siliziumcarbid zuzubereiten, indem die sic -Quelle am Boden eines zylindrischen dichten Graphit -Tiegels platziert wird, und der SIC -Samenkristall wird in der Nähe der Tiegelabdeckung platziert. Der Schmelztiegel ist durch Funkfrequenzinduktion oder -widerstand auf 2 300 ~ 2 400 ℃ erhitzt und wird durch Graphitfilm isoliert oder isoliertporöser Graphit. Die wichtigsten Substanzen, die von der sic -Quelle zum Samenkristall transportiert werden, sind Si2C -Moleküle und SIC2. Die Temperatur am Samenkristall wird so gering wie möglich als die am unteren Mikropulver, und im Tiegel wird ein axialer Temperaturgradient gebildet. Wie in Abbildung 1 gezeigt, untergräbt der Siliziumkarbid-Mikropulver bei hoher Temperatur Reaktionsgase mit verschiedenen Gasphasenkomponenten, die den Samenkristall mit einer niedrigeren Temperatur unter dem Antrieb des Temperaturgradienten erreichen und darauf kristallisieren, um einen zylindrischen Siliziumkarbid-Ingot zu bilden.
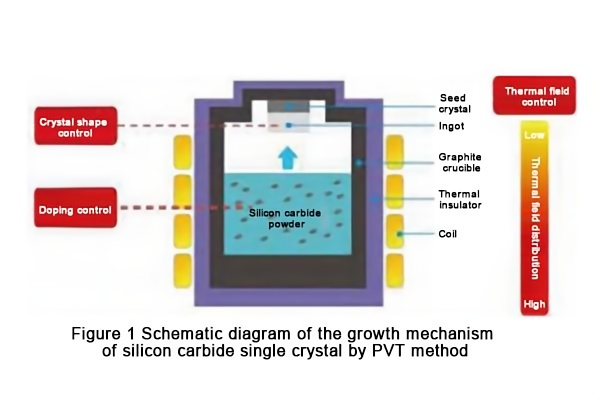
Die wichtigsten chemischen Reaktionen des PVT -Wachstums sind:
Sic (s) ⇌ si (g)+c (s)
2sic ⇌ und2C (g)+c (s)
2sic ⇌ sic2 (g)+si (l, g)
Sic (s) ⇌ sic (g)
Die Eigenschaften des PVT -Wachstums von SIC -Einzelkristallen sind:
1) Es gibt zwei Gas-Solid-Grenzflächen: Eine ist die Grenzfläche zwischen Gasschallpulver und die andere ist die Gaskristallschnittstelle.
2) Die Gasphase besteht aus zwei Arten von Substanzen: Eins ist die in das System eingeführten inerten Moleküle; Das andere ist die Gasphasenkomponenten -SIMCN, die durch die Zersetzung und Sublimation von erzeugt wirdSic pulver. Die Gasphasenkomponenten SIMCN interagieren miteinander, und ein Teil der sogenannten kristallinen Gasphasenkomponenten-SIMCN, die die Anforderungen des Kristallisationsprozesses erfüllen, wächst in den SIC-Kristall.
3) In the solid silicon carbide powder, solid-phase reactions will occur between particles that have not sublimated, including some particles forming porous ceramic bodies through sintering, some particles forming grains with a certain particle size and crystallographic morphology through crystallization reactions, and some silicon carbide particles transforming into carbon-rich particles or carbon particles due to non-stoichiometric decomposition and Sublimation.
4) Während des Kristallwachstumsprozesses treten zwei Phasenänderungen auf: Eine ist, dass die festen Silizium-Carbid-Pulverpartikel in Gasphasenkomponenten SIMCN durch nicht stöchiometrische Zersetzung und Sublimation umgewandelt werden, und die andere ist, dass die Gasphasenkomponenten Simcn durch Kristallisation in Gitterpartikel umgewandelt werden.
2 Ausrüstungsdesign
Wie in Abbildung 2 gezeigt, umfasst der einkristallwachstumsofen aus dem Siliziumcarbid hauptsächlich: obere Abdeckungsbaugruppe, Kammerbaugruppe, Heizsystem, Tiegel -Drehmechanismus, Mechanismus des unteren Abdeckungshubs und elektrisches Kontrollsystem.

2.1 Heizsystem
Wie in Abbildung 3 gezeigt, übernimmt das Heizsystem Induktionsheizung und besteht aus einer Induktionsspule aGraphit Crucible, eine Isolationsschicht (starres Gefühl, weicher Filz) usw. Wenn die mittlere Frequenz abwechselnd durch die Multiturn-Induktionsspule der Außenseite des Graphit-Tiegels fließt, wird im Graphit-Tiegel ein induziertes Magnetfeld derselben Frequenz gebildet, wodurch eine induzierte elektromotive Kraft erzeugt wird. Da das hochreinheitliche Graphit-Schmelzmaterial eine gute Leitfähigkeit aufweist, wird an der Tiegelwand ein induzierter Strom erzeugt, der einen Wirbelstrom bildet. Unter der Wirkung der Lorentz -Kraft konvergiert der induzierte Strom schließlich an der Außenwand des Schmelztiegels (d. H. Der Hauteffekt) und schwächer nach allmählich entlang der radialen Richtung. Aufgrund der Existenz von Wirbelströmen wird Joule Wärme an der Außenwand des Schmelztiegels erzeugt und wird zur Heizungsquelle des Wachstumssystems. Die Größe und Verteilung von Joule Wärme bestimmen direkt das Temperaturfeld im Schmelztiegel, was wiederum das Wachstum des Kristalls beeinflusst.
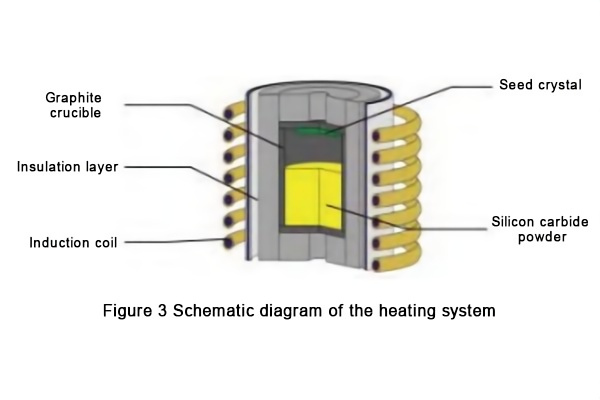
Wie in Abbildung 4 gezeigt, ist die Induktionsspule ein wesentlicher Bestandteil des Heizsystems. Es nimmt zwei Sätze unabhängiger Spulenstrukturen an und ist mit oberen und unteren Präzisionsbewegungsmechanismen ausgestattet. Der größte Teil des elektrischen Wärmeverlusts des gesamten Heizsystems wird von der Spule getragen, und die erzwungene Kühlung muss durchgeführt werden. Die Spule ist mit einer Kupferrohr verwundet und durch Wasser im Inneren abgekühlt. Der Frequenzbereich des induzierten Stroms beträgt 8 ~ 12 kHz. Die Frequenz der Induktionsheizung bestimmt die Penetrationstiefe des elektromagnetischen Feldes im Graphit -Tiegel. Der Spulenbewegungsmechanismus verwendet einen motorgetriebenen Schraubenpaarmechanismus. Die Induktionsspule kooperiert mit der Induktionsstromversorgung, um den internen Graphit -Schmelztiegel zu erhitzen, um die Sublimation des Pulvers zu erreichen. Gleichzeitig werden die Leistung und die relative Position der beiden Spulensätze kontrolliert, um die Temperatur am Samenkristall niedriger zu machen als die am unteren Mikropulver, wodurch ein axialer Temperaturgradient zwischen dem Samenkristall und dem Pulver im Schmelztiegel gebildet wird und einen vernünftigen Radialtemperaturgradienten am Siliziumkarbidkristall bildet.

2.2 Tiegel -Rotationsmechanismus
Während des Wachstums von großer GrößeEinzelkristalle aus SiliziumkarbidDas Schmelztiegel in der Vakuumumgebung des Hohlraums wird nach den Prozessanforderungen gedreht, und das Thermalfeld des Gradienten und der Niederdruckzustand im Hohlraum müssen stabil gehalten werden. Wie in Abbildung 5 gezeigt, wird ein motorgetriebenes Zahnradpaar verwendet, um eine stabile Rotation des Schmelztiegels zu erreichen. Eine magnetische Flüssigkeitsdichtungsstruktur wird verwendet, um eine dynamische Versiegelung der rotierenden Schacht zu erreichen. Die magnetische Flüssigkeitsdichtung verwendet einen rotierenden Magnetfeldkreis zwischen dem Magneten, dem Magnetpolschuh und der Magnethülle, um die Magnetflüssigkeit zwischen der Polschuhspitze und der Hülse fest zu adsorbieren, um einen O-Ring-ähnlichen Fluidring zu bilden, um den Spalt vollständig zu blockieren, um den Abdichtungszweck zu erzielen. Wenn die Rotationsbewegung von der Atmosphäre in die Vakuumkammer übertragen wird, wird die dynamische Dichtungsvorrichtung von Flüssigkeiten O-Ring verwendet, um die Nachteile von einfachem Verschleiß und niedriger Lebensdauer bei fester Dichtung zu überwinden, und die flüssige magnetische Flüssigkeit kann den gesamten versiegelten Raum füllen, wodurch alle Kanäle gelöscht werden können, die Luft und Anhören in den beiden Verfahren der Vorsätze und der Aufhören von Null-Leakage in den beiden Verfahren der Verfahren und der Aufhören durchführen können. Die magnetische Flüssigkeit und die Tiegelunterstützung verwenden eine Wasserkühlstruktur, um die Hochtemperaturanwendbarkeit der magnetischen Flüssigkeit und des Tiegelträgers zu gewährleisten und die Stabilität des thermischen Feldzustands zu erreichen.

2.3 Mechanismus für niedrigere Abdeckungshebe
Der untere Abdeckungsmechanismus besteht aus einem Antriebsmotor, einer Kugelschraube, einer linearen Führung, einer Hebelhalterung, einer Ofenabdeckung und einer Ofenabdeckungsklasse. Der Motor treibt die mit dem Schraubenführerpaar angeschlossene Ofenabdeckungshalterung durch einen Reduzierer an, um die Auf- und Abbewegung der unteren Abdeckung zu realisieren.
Der Mechanismus mit niedrigerer Abdeckungserlebnis erleichtert die Platzierung und Entfernung großer Tiegel und stellt vor allem die Versiegelungszuverlässigkeit der unteren Ofenabdeckung sicher. Während des gesamten Prozesses hat die Kammer Druckänderungsstadien wie Vakuum, Hochdruck und niedrigem Druck. Der Kompressions- und Versiegelungszustand der niedrigeren Abdeckung wirkt sich direkt auf die Prozesszuverlässigkeit aus. Sobald die Siegel bei hoher Temperatur ausfällt, wird der gesamte Vorgang verschrottet. Durch die Steuerung und Grenzvorrichtung von Motor Servo wird die Dichtheit der unteren Abdeckungsbaugruppe und die Kammer gesteuert, um den besten Kompressions- und Versiegelungszustand des Dichtungsrings der Ofenkammer zu erreichen, um die Stabilität des Prozessdrucks zu gewährleisten, wie in Abbildung 6 gezeigt.
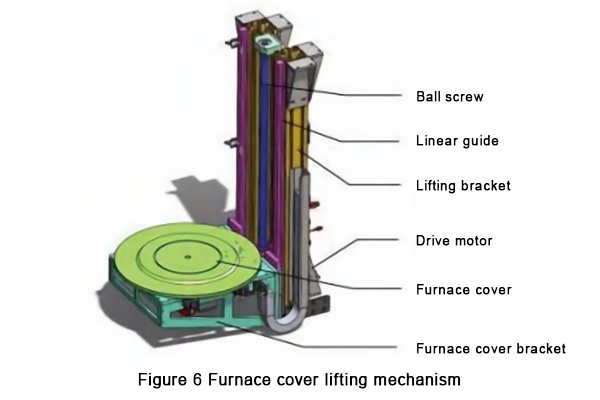
2.4 elektrisches Steuerungssystem
Während des Wachstums von Siliziumcarbidkristallen muss das elektrische Kontrollsystem unterschiedliche Prozessparameter genau steuern, hauptsächlich einschließlich der Spulenpositionshöhe, der Tiegeldrehrate, der Heizleistung und der Temperatur, der unterschiedlichen Spezialgasanschließungsströmungen und der Öffnung des Proportionsventils.
Wie in Abbildung 7 gezeigt, verwendet das Steuerungssystem einen programmierbaren Controller als Server, der über den Bus mit dem Servo -Treiber verbunden ist, um die Bewegungssteuerung der Spule und des Tiegels zu realisieren. Es ist über den Standard-MOBUSRtu mit dem Temperaturregler und dem Durchflussregler verbunden, um die Echtzeitregelung von Temperatur, Druck und speziellem Prozessgasfluss zu realisieren. Es stellt die Kommunikation mit der Konfigurationssoftware über Ethernet fest, tauscht Systeminformationen in Echtzeit aus und zeigt verschiedene Prozessparameterinformationen auf dem Host -Computer an. Operatoren, Prozesspersonal und Manager tauschen Informationen über die Human-Machine-Schnittstelle mit dem Steuerungssystem aus.

Das Steuerungssystem führt die gesamte Felddatenerfassung, die Analyse des Betriebsstatus aller Aktuatoren und die logische Beziehung zwischen den Mechanismen durch. Der programmierbare Controller empfängt die Anweisungen des Host -Computers und vervollständigt die Steuerung jedes Aktuators des Systems. Die Ausführungs- und Sicherheitsstrategie des automatischen Prozessmenüs wird vom programmierbaren Controller ausgeführt. Die Stabilität des programmierbaren Controllers gewährleistet die Stabilität und Sicherheitszuverlässigkeit des Vorgangs des Prozesses.
Die obere Konfiguration verwaltet den Datenaustausch mit dem programmierbaren Controller in Echtzeit und zeigt Felddaten an. Es ist mit Betriebsgrenzflächen wie Heizsteuerung, Druckregelung, Gasschaltungsregelung und Motorsteuerung ausgestattet, und die Einstellungswerte verschiedener Parameter können an der Grenzfläche geändert werden. Echtzeitüberwachung von Alarmparametern, Bildschirmalarmanzeige, Aufzeichnung der Zeit und detaillierte Daten zum Auftreten und der Wiederherstellung von Alarms. Echtzeitaufzeichnung aller Prozessdaten, Bildschirmbetriebsinhalt und Betriebszeit. Die Fusionskontrolle verschiedener Prozessparameter wird durch den zugrunde liegenden Code innerhalb des programmierbaren Controllers realisiert, und maximal 100 Prozessschritte können realisiert werden. Jeder Schritt enthält mehr als ein Dutzend Prozessparameter wie Prozessbetriebszeit, Zielleistung, Zieldruck, Argonströmung, Stickstofffluss, Wasserstofffluss, Tiegelposition und Tiegelgeschwindigkeit.
3 Analyse der thermischen Feldsimulationsanalyse
Das Modell der thermischen Feldsimulationsanalyse wird festgelegt. Abbildung 8 ist die Temperaturwolkenkarte in der Tiegelwachstumskammer. Um den Wachstumstemperaturbereich von 4H-SIC-Einzelkristall zu gewährleisten, wird die Mitteltemperatur des Samenkristalls mit 2200 ° C berechnet und die Kantentemperatur 2205,4 ℃ beträgt. Zu diesem Zeitpunkt beträgt die mittlere Temperatur des Schmelzoberteils 2167,5 ° und die höchste Temperatur des Pulverbereichs (Seite nach unten) 2274,4 ° C und bildet einen axialen Temperaturgradienten.

Die radiale Gradientenverteilung des Kristalls ist in Abbildung 9 dargestellt. Der niedrigere laterale Temperaturgradient der Samenkristalloberfläche kann die Kristallwachstumsform effektiv verbessern. Der Strom berechnete die anfängliche Temperaturdifferenz beträgt 5,4 ° und die Gesamtform ist nahezu flach und leicht konvex, wodurch die Genauigkeit und Gleichmäßigkeit der radialen Temperatur der Samenkristalloberfläche erfüllt werden kann.

Die Temperaturdifferenzkurve zwischen der Rohstoffoberfläche und der Samenkristalloberfläche ist in Abbildung 10 dargestellt. Die mittlere Temperatur der Materialsoberfläche beträgt 2210 ° und ein Längs -Temperaturgradient von 1 ℃/cm zwischen der materiellen Oberfläche und der Samenkristalloberfläche, die sich innerhalb eines vernünftigen Bereichs befindet.
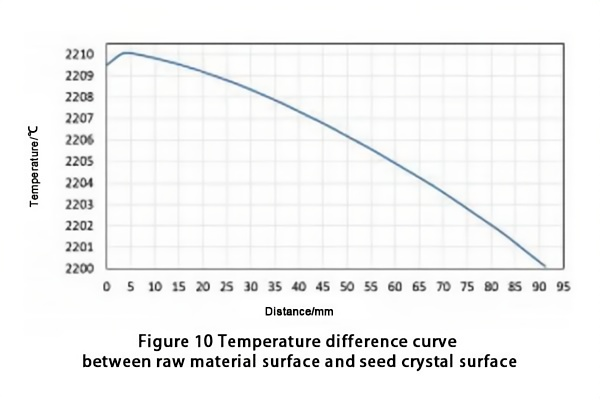
Die geschätzte Wachstumsrate ist in Abbildung 11 dargestellt. Eine zu schnelle Wachstumsrate kann die Wahrscheinlichkeit von Defekten wie Polymorphismus und Versetzung erhöhen. Die derzeit geschätzte Wachstumsrate liegt nahe bei 0,1 mm/h, was in einem angemessenen Bereich liegt.

Durch die Analyse und Berechnung der thermischen Feldsimulationsanalyse und Berechnung wurde festgestellt, dass die Mitteltemperatur und die Kantentemperatur des Samenkristalls den Radialtemperaturgradienten des Kristalls von 8 Zoll erfüllen. Gleichzeitig bilden die Ober- und Unterseite des Schmelztiegels einen axialen Temperaturgradienten, der für die Länge und Dicke des Kristalls geeignet ist. Die aktuelle Heizmethode des Wachstumssystems kann das Wachstum von 8-Zoll-Einzelkristallen entsprechen.
4 Experimenteller Test
VerwendenSiliziumkarbid -EinkristallwachstumofenBasierend auf dem Temperaturgradienten der thermischen Feldsimulation wurde durch Einstellen der Parameter wie der Tiegeltemperatur, des Hohlraumdrucks, der Tiegel-Drehgeschwindigkeit und der relativen Position der oberen und unteren Spulen ein Silizium-Carbid-Kristallwachstumstest durchgeführt, und es wurde ein 8-Zoll-Siliziumkristallkristall durchgeführt (wie in Abbildung 12 gezeigt).

5 Schlussfolgerung
Die Schlüsseltechnologien für das Wachstum von 8-Zoll-Silizium-Carbid-Einzelkristallen wie Thermofeld, Tiegelbewegungsmechanismus und automatische Kontrolle der Prozessparameter wurden untersucht. Das thermische Feld in der Tiegelwachstumskammer wurde simuliert und analysiert, um den idealen Temperaturgradienten zu erhalten. Nach dem Test kann die Methode zur Heizung mit Doppel-Coil-Induktion das Wachstum von großer Größe erfüllenSiliziumkarbidkristalle. Die Forschung und Entwicklung dieser Technologie bietet Ausrüstungstechnologie für die Erlangung von 8-Zoll-Carbidkristallen und die Grundlage für den Übergang der Siliziumcarbid-Industrialisierung von 6 Zoll auf 8 Zoll, wodurch die Wachstumseffizienz von Siliziumcarbidmaterialien verbessert und die Kosten gesenkt werden.



+86-579-87223657


Wangda Road, Ziyang Street, Kreis Wuyi, Stadt Jinhua, Provinz Zhejiang, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alle Rechte vorbehalten.
Links | Sitemap | RSS | XML | Datenschutzrichtlinie |
